Лазерный сканирующий конфокальный цветной микроскоп OPTELICS HYBRID
Многофункциональный высокопроизводительный световой конфокальный и лазерный конфокальный микроскоп OPTELICS HYBRID обладает целым рядом преимуществ: 2 вида конфокальной оптики в одном микроскопе, интерферометр на фазовом сдвиге, возможность наблюдения в дифференциально интерференционном контрасте, измерение толщин тонких пленок методом спектроскопической рефракции.
Скачать брошюру.

Особенности
- 24битное цветное наблюдение высокого разрешения
- Широкопольные наблюдения и измерения
- Определение толщин прозрачных пленок
- Высокое увеличение
- Высокое разрешение
- Высокая контрастность
- Визуализация нанометровых дефектов, трещин, частиц на ровной поверхности
Аналитические функции
Профиль / сравненительные измеренияИзмерение формы поверхности на заданной пользователем линии.
Измерение сравнения для измерения разницы в нескольких строках.
Критерии измерения: ширина, высота, угол, уточненный радиус, отклонение

Измерения ширины и шага
Идеально подходит для измерения ширины полупроводниковых паттернов. Лучшая в отрасли точность и повторяемость достигается с помощью уникальной оптики и детекторов.
- Точность:
± [0,02 x (100 / увеличение объективами) + L / 1000] мкм
(Ex. ± 0.025 µm для ширины линии 5 мкм)
-
Повторяемость:
3σ = 0.01µm
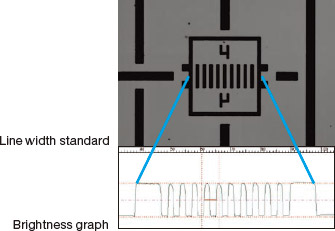
Измерение шероховатости поверхности
Измерение шероховатости поверхности в соответствии с параметрами JIS и ISO. Высокое разрешение измерения шероховатости возможно для любого типа образцов благодаря бесконтактному методу измерений.
-
2 мерная шероховатость
Шероховатость поверхности: Ra, Rp, Rv, Rc, Rt, Rq, Rsm, Rk, Rpk, Rvk и т.д.
JIS B 0671: Rk, Rpk, Rvk, Mr1, Mr2, А1, А2 и т.д.
Rmr - 3D шероховатость
Параметры шероховатости: Sa, Sp, Sv, Sz, пл и т.д.
Параметры объема: Sk, SPK, СВК, SMR1, ВВК, VVV и т.д.

Анализ геометрических свойств
HYBRID анализирует более 20 свойств, включая площадь, объем, положение центра тяжести и т.д. Вывод результата анализа доступен в формате электронной таблицы.

2D измерения
Измерение 2 мерных функций, таких как длина, угол, радиус и т.п.

Измерение перепадов высот
Измерение разницы высот в указанной пользователем области
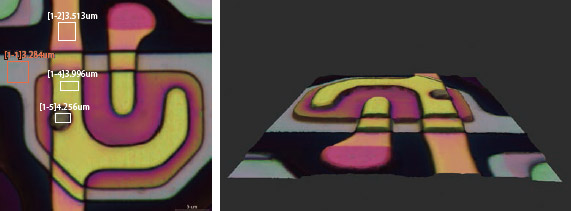
Измерение толщины пленки (XZ поперечные измерения)
Толщина пленки получают путем оптических вычислений расстояния между поверхностью пленки и поверхности подложки с использованием отраженного света. Пример: PI пленки на подложке.

Управление данными результатов экспериментов
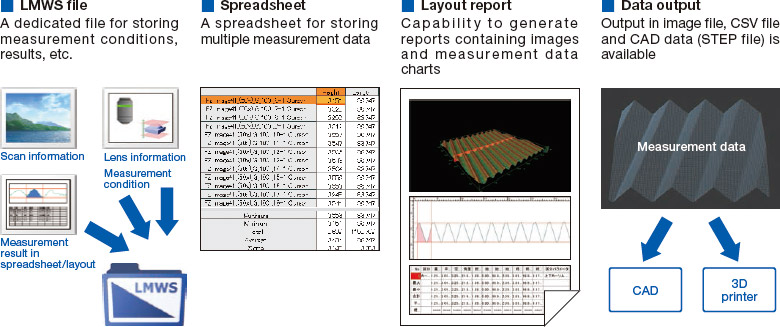
Высокая скорость и высокая точность измерений
- Ведущая в отрасли скорость измерения. HYBRID достигает частоту кадров 15 Гц, примерно в 4 раза быстрее, чем типичный CLSM(конфокальный лазерный сканирующий микроскоп, что делает его мощным инструментом для высокоскоростного авто измерений, пэчворка и высокоскоростного наблюдения.
- Высоко скоростной пэчворк. Эта функция позволяет сшить большой объект, как показано на рисунке из множества небольших лоскутков изображений. Это плавно создает широкий FOV изображение. Время процесса составляет около 1/6, что требуется для типичного CLSM. (Количество экранов : 1 / 1.5, измерение времени на экране: 1/4)
- Высокоскоростная автоматическая оптимизация диапазона измерения. В пэчворк, высота зазора в пределах каждого FOV автоматически определяется для автонастройки диапазона измерений. Это предотвращает ошибки ввода данных по изображению и значительно сокращает время сканирования.
- Маппинг отображение областей изображения. Текущее позиция проводимых измерений может быть отображена в более широком FOV изображения. Эта функция также позволяет перейти к точке измерения одним щелчком мыши, авто пэчворк в указанной области на карте и координировать управление информацией в указанной позиции.
-
Лучшая в отрасли точность измерений и повторяемость.
Высокая точность требуется для измерительных инструментов.
Высокая точность:
Ширина линии: ± [0.02x (100 / цель) + L / 1000] мкм
Измерение высоты: ± (0,11 + L / 100) мкм
-
Высокий уровень повторяемости.
Линия 3σ измерение ширина: 10 нм
Измерение высоты: 10нм
HYBRID достигает отрасли воспроизводимости и обнаруживает истинный пик, расположенный в зазоре измерения на основе IZ кривой, рассчитанной с помощью специального алгоритма.
Оптические интерференционные измерения
Измерение высоты нанометрового масштаба в широком поле зрения. Возможно проведение точных наноизмерений высоты в миллиметровом масштабе FOV.Особенности
Разрешение при измерении высоты с использованием оптической интерференции не зависит от линзы объектива NA. Поэтому возможно иметь высокое разрешение, даже в широком поле зрения. Это подходит для измерения сверхтонких вогнутости / выпуклости, шероховатости поверхности и неровностей при сохранении миллиметрового масштаба широкоугольного обзора. Вы можете значительно расширить диапазон измерительных применений, дополняя этот метод с конфокальностью, который больше подходит для измерения склонов и шероховатых поверхностей.

Основной принцип оптических интерференционных измерений
профили поверхности измеряются в нанометровом разрешении от анализа моделей интерференции, создаваемых интерференцией объективов. Свет разбивается на два массива с помощью светоделителя внутри объектива. Один из массивов отражается поверхностью образца, в то время как другой массив переходит к референтному зеркалу и отражается. Оба отраженных луча накладываются на линзу объектива для формирования интерференционных картин, вызванных оптическими разности хода. По мере того как инструмент настроен так, что он не имеет оптической разности хода в положении фокуса, интерференционные полосы указывают на впадины и выпуклости на поверхности образца.
Вертикально-сканировующая интерферометрия белого света
Интерференционные полосы имеют сильный контраст на плоскости в фокусе. Пик яркости в интерференционной полосы определяется для измерения высоты с надежностью конфокальной микроскопии.

Интерферометрия сдвига фазы
Измерение высоты в Ангстрем масштабе степени точности измерений от фазового анализа интерференционных полос в одной длине волны света (546 нм), которые получаются, поскольку фаза изменяется в несколько этапов. Диапазон измерений ограничен в пределах половины длины волны, но время измерения составляет несколько секунд.
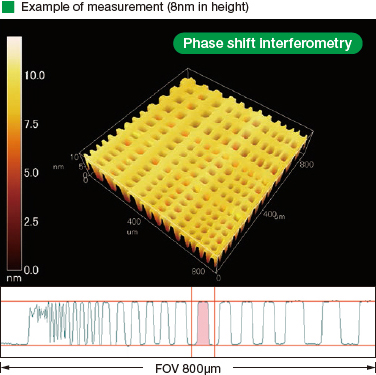
Измерение толщины пленок методом спектральной рефлектометрии
Измерение толщины прозрачной пленки. Вы можете измерить толщину прозрачных пленок, используя возможность выбора 6 длин волн в белом свете. Область измерения настраивается пользователем . Эта функция применима либо к поверхностнопокрытым пленкам или узорчатым пленкам. Спектроскопическая рефлектометрия доступна для измерения прозрачной пленки толщиной в нанометровом масштабе. Это компенсирует недостаток софокусной оптики, которая не может обнаружить позицию фокусировки для пленки с толщиной, близкой к длине волны света, таким образом, не пригодной для измерения толщины.
Принцип спектроскопической рефлектометрии
Толщина пленки может быть измерена с использованием спектра отражения, полученного с помощью спектроскопической рефлектометрии после настройки параметров с оптической имитационной моделью. Отраженный спектр показывает зависимость между абсолютной отражательной способностью и длиной волны. Она изменяется в зависимости от толщины пленки и оптических констант. Абсолютный коэффициент отражения определяется интерференцией тонкой пленки , вызванной многократным отражением света между поверхностью пленки и подложки.

Шесть длин волн выбраны из белого света для получения отраженного изображения для каждого из них и вычисления отражательной способности. Оптические константы (показатель преломления и коэффициент экстинкции) для тонких пленок и подложек используются в оптической модели для расчета абсолютного коэффициента отражения от коэффициента Френеля и измерения толщины пленки после настройки параметров.
Широкопольные конфокальные наблюдения в белом свете
Широкий FOV для эффективного наблюденияFOV в 1,6 раза шире, чем типичный CLSM (конфокальный лазерный сканирующий микроскоп).
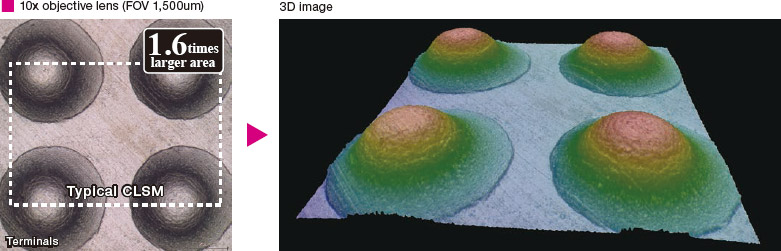
Высокая точность измерений при малом увеличении
С помощью наших специальных объективов, стало возможным проводить высоко точные измерения при малом увеличении, что трудно достичь при стандартном CLSM. Объектив разработан специально для широкого поля зрения и высокой точности измерений, High-NA (высокое значение цифровой апертуры) линзы объектива с увеличением 5x, 10x, 20x.
| Увеличение | Нормальные объективы NA | Специальные объективы NA | FOV |
|---|---|---|---|
| 5x | 0.15 | 0.25 | 3,000x3,000μm |
| 10x | 0.30 | 0.50 | 1,500x1,500μm |
| 20x | 0.45 | 0.75 | 750x750μm |

Широкий FOV и высокая точность
HYBRID FOV в 6,7 раза шире, чем у обычных CLSM благодаря широким FOV и использованию специальных объективов с высокой числовой апертурой .
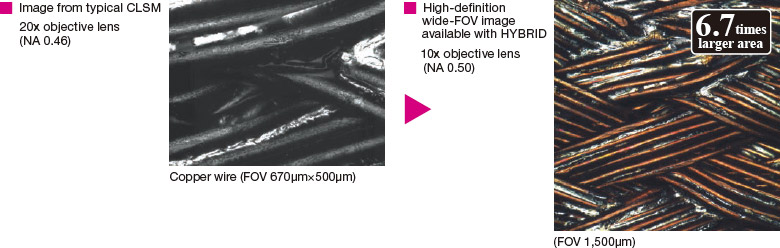
Наблюдение конфокальных изображений высокой четкости в белом свете
При использовании ксеноновой лампы освещение похоже на солнечный свет в качестве источника света, становятся доступны изображения высокой четкости с хорошим разделением цветов и высокой глубиной резкости.


Расширение применения с переключением каналов детектора
Переключение детектора канала позволяет проводить наблюдения и измерения в наиболее подходящей длине волны. Она также расширяет ваши применения для образцов, для которых лазерный луч не может обеспечить четкую картину.


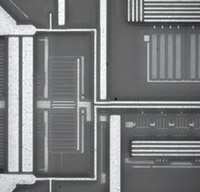
Расширение применения с переклюением между разными длинами волн
Возможен выбор из 6 различных длин волн источника света. Это позволяет выбрать оптимальную длину волны для вашего наблюдения и измерения и расширяет ваши возможности анализа к образцам, чувствительным к повреждениям в определенной длине волны света, таких как резистивная пленка или УФ-отверждаемые смолы и образцы, которые поглощают определенную длину волны света.
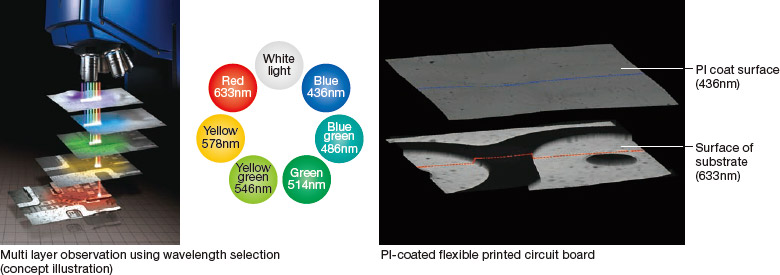
Лазерные конфокальные наблюдения
Лазер 405 нм позволяет захватывать изображение в одно мгновение с возможностью четкой визуализации ультратонких структур.Ниобат Натрия - наблюдение домена
(FOV 25 мкм, 11,000x увеличение на мониторе)

Наблюдение Si пластины
(FOV 75um, 3,700x увеличение на мониторе)

Полимерная смесь кристаллов
(FOV150um, 1,850x увеличение на мониторе)

3D-изображение полимерной смеси кристаллов
(FOV150um)

Текстура ячейки солнечной панели
(FOV50um, 5,500x увеличение на мониторе)

Активный материал литий-ионного аккумулятора
(FOV75um, 3,700x увеличение на мониторе)

Сравнение с цифровым оптическим микроскопом


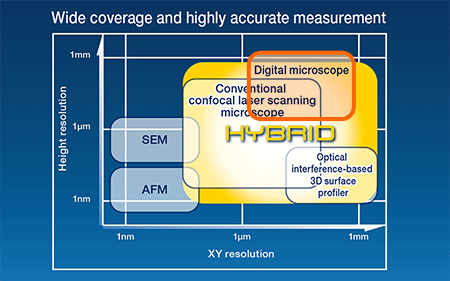

Сравнение с интерферометрическим профилометром


Сравнение с традиционным лазерным микрооскопом